タイセーの研磨事業は、サファイア研磨事業で培った技術を更に高精度化しております。
当社の強み
・枚葉式研磨機で1枚からの加工が可能
・揺動式の採用で平坦度が優れている
自社製作研磨機
・4軸揺動式研磨機、スラリー循環式CMP機、生産冶具は自社製作
・増設、故障も迅速に対応
品質面
・平坦度 2.5μm以内(目標)
・面粗度 Ra 1Å以内(0.1nm)
・仕上げ洗浄(RCA洗浄に準ずる)
枚葉加工で1枚からの加工が可能
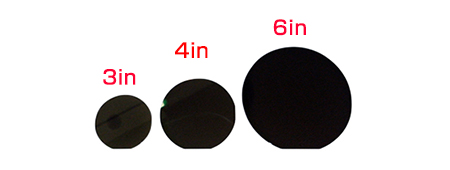
エピ膜保護テープによる裏面研磨加工等
ニーズに合わせた加工が可能
研磨対象製
ベアウエハの指定面CMP加工
エピウエハの指定面CMP再生加工
プロセスウエハの裏面加工
*指定面:Si面・C面
サイズ:1.5インチφ、2インチφ
3インチφ 4インチφ
6インチφ
1枚から受託可能
・エピ 再生研磨
・ベア基板研磨
・研削、ダイヤスラリー研磨、CMP研磨
・除去量
ベアウエハCMP:基板最小厚部より10μm以内
再生ウエハCMP:指定厚み±5μm以内
・面粗さ
Si面=<0.1nm
C面=<0.2nm
・TTV
<5μm以内(2.5μm以下目標)
・加工厚:状況により対応
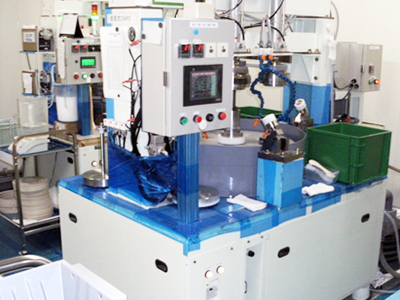
1次研磨機
洗浄
・ワックス、スラリー除去
・RCA洗浄に準ずる洗浄
TXRF評価 (外部委託2回/年)
・洗浄装置
クイックダンプ
1槽~6槽 超音波槽、薬品槽、リンス槽
ベーパー槽での乾燥洗浄仕上げ
・パーティクル:0.3μm以上15個以内

洗浄機
検査
・カンデラによる解析
カンデラマップ
生画像によるスクラッチ、結晶欠陥検査
スクラッチ面粗度検査 Ra<0.1nm
平坦度 TTV<5μm
・集光灯下目視両面検査

Candela

モニター

解析画面
異種ウエハの研磨挑戦
SiC
6インチφ以上への挑戦
GAN
CMP研磨
酸化ガリウム
CMP研磨